
Рефераты по авиации и космонавтике
Рефераты по административному праву
Рефераты по безопасности жизнедеятельности
Рефераты по арбитражному процессу
Рефераты по архитектуре
Рефераты по астрономии
Рефераты по банковскому делу
Рефераты по сексологии
Рефераты по информатике программированию
Рефераты по биологии
Рефераты по экономике
Рефераты по москвоведению
Рефераты по экологии
Краткое содержание произведений
Рефераты по физкультуре и спорту
Топики по английскому языку
Рефераты по математике
Рефераты по музыке
Остальные рефераты
Рефераты по биржевому делу
Рефераты по ботанике и сельскому хозяйству
Рефераты по бухгалтерскому учету и аудиту
Рефераты по валютным отношениям
Рефераты по ветеринарии
Рефераты для военной кафедры
Рефераты по географии
Рефераты по геодезии
Рефераты по геологии
Рефераты по геополитике
Рефераты по государству и праву
Рефераты по гражданскому праву и процессу
Рефераты по кредитованию
Рефераты по естествознанию
Рефераты по истории техники
Рефераты по журналистике
Рефераты по зоологии
Рефераты по инвестициям
Рефераты по информатике
Исторические личности
Рефераты по кибернетике
Рефераты по коммуникации и связи
Рефераты по косметологии
Рефераты по криминалистике
Рефераты по криминологии
Рефераты по науке и технике
Рефераты по кулинарии
Рефераты по культурологии
Курсовая работа: Фізико-технологічні основи металізації інтегральних схем
Курсовая работа: Фізико-технологічні основи металізації інтегральних схем
МІНІСТЕРСТВО ОСВІТИ І НАУКИ УКРАЇНИ
ДЕРЖАВНИЙ ВИЩИЙ НАВЧАЛЬНИЙ ЗАКЛАД
Фізико–технологічні основи металізації інтегральних схем
Курсова робота
З курсу "Технологічні основи електроніки"
ВСТУП
РОЗДІЛ 1. ЕЛЕМЕНТИ І КОМПОНЕНТИ ІНТЕГРАЛЬНИХ МІКРОСХЕМ
1.1 Підкладки інтегральних схем
1.2 Елементи ІС
РОЗДІЛ 2. ТЕХНОЛОГІЯ ВИРОБНИЦТВА ІНТЕГРАЛЬНИХ МІКРОСХЕМ
2.1 Масковий метод
2.2 Метод фотолітографії
2.3 Комбінований метод
РОЗДІЛ 3. МЕТОДИ МЕТАЛІЗАЦІЇ ІНТЕГРАЛЬНИХ СХЕМ
3.1 Термічне (вакуумне) напилення
3.2 Катодне напилення
3.3 Іонно-плазмове напилення
3.4 Анодування
3.5 Електрохімічне осадження
ВИСНОВКИ
ЛІТЕРАТУРА
ВСТУП
Реалізація принципів, ідей, методів напівпровідникової мікроелектроніки привела до створення інтегральних схем, що є цілими пристроями і навіть системами, розміщеними в одному напівпровідниковому кристалі. Проте не всі пристрої можна виготовити за допомогою напівпровідникової технології.
Паралельно з напівпровідниковим розвинувся і удосконалювався інший конструктивно-технологічний варіант створення мікроелектронних пристроїв, заснований на технології тонких (до 1 мкм) і порівняно товстих (10 – 50 мкм) плівок. Чисто пасивні плівкові ІМС не набули широкого поширення через обмеження можливостей по виконанню ними функцій обробки сигналів, а реалізація плівкових активних елементів виявилася неможливою через низьку відтворюваність їх характеристик. Поєднання напівпровідникових мікросхем, активних напівпровідникових приладів з пасивними плівковими елементами і плівковою комутацією дозволила створити мікроелектронні пристрої з широким набором функціональних можливостей.
РОЗДІЛ 1. ЕЛЕМЕНТИ І КОМПОНЕНТИ ІНТЕГРАЛЬНИХ МІКРОСХЕМ
1.1 Підкладки інтегральних схем
Підкладки ІС є діелектричною і механічною підставою для плівкових і навісних елементів і служать тепловідводом. Матеріал підкладки повинен володіти наступними властивостями і характеристиками:
1) високим опором ізоляції і електричною міцністю;
2) великим коефіцієнтом теплопровідності для ефективної передачі теплоти від тепловиділяючих елементів (резисторів, діодів, транзисторів) до корпусу мікросхеми;
3) достатньою механічною міцністю;
4) стійкістю до дії хімічних реактивів в процесі підготовки поверхні підкладки перед нанесенням плівок;
5) стійкістю до дії нагріву в процесі нанесення тонких плівок і термообробки товстих плівок;
6) здібністю до механічної обробки (різанню і так далі).
Структура матеріалу підкладки і стан її поверхні впливають на параметри плівкових елементів. Велика шорсткість поверхні підкладки знижує надійність тонкоплівкових резисторів і конденсаторів, оскільки мікронерівності зменшують товщину плівок резисторів. При товщині плівок близько 100 нм допускається висота мікронерівностей приблизно 25 нм. Товсті плівки мають товщину 10 – 50 мкм, тому підкладки для товстоплівкових ІМС можуть мати мікронерівності 1 – 2 мкм. [1]
1.2 Елементи ІС
Інтегральні мікросхеми складаються з ізолюючої підстави (підкладки), на поверхні якого розміщені плівкові елементи (резистори, конденсатори, спіралі індуктивності, провідники і контактні площадки), а також навісні безкорпусні мініатюрні активні (транзистори, діоди, напівпровідникові) і пасивні (конденсатори, котушки індуктивності і так далі) компоненти. Для захисту ІС поміщають в корпус. [3]
Плівкові резистори
Плівковий резистор розташовують на поверхні діелектричної підкладки, конструктивно він складається з резистивної плівки певної конфігурації і контактних площадок.
Розміри контактної області повинні вибиратися такими, щоб при якнайгірших поєднаннях геометричних розмірів резистивного шару і контактних площадок резистивна і провідна плівки перекривалися, забезпечуючи малий перехідний опір контакту в низькоомних резисторах. Як резистивні матеріали тонкоплівкових резисторів використовують чисті метали і сплави з високим електричним опором, а також спеціальні матеріали – кермети, які складаються з частинок металу і діелектрика (наприклад, Cr і SIO).
Широко поширені плівки хрому і танталу. На основі керметів, до складу яких входять хром і монооксид кремнію, отримують високоомні резистори. Для виготовлення товстоплівкових резисторів застосовують пасти, що складаються з порошку скла, наповнювача і органічної зв'язки. Широко використовують свинцеві і цинкові борсилікатні стекла. Як наповнювач резистивних паст застосовують срібло, паладій і їх сплави. [2]
Резистори, що підганяються
Застосовують плавну і ступінчасту підгонку опору резисторів. Плавна підгонка забезпечує точність до сотих доль відсотка, ступінчаста – до одиниць відсотків. Плавну підгонку опору тонкоплівкових резисторів здійснюють, змінюючи або питомий поверхневий опір, або форму резистивної плівки.
Питомий поверхневий опір змінюють шляхом термічної, хімічної або механічної дії на матеріал плівки. Форму резистивної плівки коректують шляхом видалення частини резистивного матеріалу.
Ступінчаста підгонка опору здійснюється видаленням металевих перемичок в підганяльних секціях. Найбільш поширений спосіб плавної підгонки, пов'язаний із зміною геометрії резистора лазерним променем. В процесі підгонки частина плівки віддаляється і опір збільшується. При лазерній підгонці спочатку проводять грубу підгонку випалюванням плівки упоперек, потім точну – уздовж резистора; випалювання резистивної плівки під кутом дозволяє сумістити грубу і точну підгонку. [1]
Плівкові конденсатори
Такі конденсатори належать до найбільш поширених елементів ІС. Конструктивно ці конденсатори є тришаровою структурою метал – діелектрик – метал (МДМ-структура) і складаються з нижнього і верхнього обкладань, розділених шаром діелектричного матеріалу.
До конструкції конденсаторів пред'являються наступні конструктивно-технологічні вимоги:
1) мінімальні габарити;
2) відтворюваність характеристик в процесі виробництва;
3) сумісність технічних процесів виготовлення конденсаторів з технологічними процесами виготовлення інших елементів ІС.
Характеристики конденсаторів визначаються властивостями використовуваних матеріалів. До діелектрика конденсаторів пред'являються наступні вимоги:
1) високі – діелектрична проникність, електрична міцність і опір ізоляції;
2) малі – температурний коефіцієнт діелектричної проникності і діелектричні втрати, хороша адгезія, сумісність з технологічними процесами виготовлення інших елементів мікросхем. [5]
Діелектрик конденсатора формується методами термічного напилення, іонно-плазмового і реактивного розпилювання.
Для виготовлення діелектричних тонких плівок застосовують монооксиди кремнію SiO і германію GеO, оксиди алюмінію Al2O3, танталу Ta2O5, титана TiO2 і рідкоземельних металів. Високі питомі ємкості мають титанати барію і кальцію. При виготовленні діелектричних шарів товстоплівкових конденсаторів використовують пасти, які містять титанат барію або діоксид титану, що мають високу діелектричну проникність. [2]
Матеріал обкладок конденсатора повинен задовольняти наступним вимогам: мати низький електричний опір обкладань, хорошу адгезію, володіти низькою міграційною рухливістю атомів, високою корозійною стійкістю. [1]
Конденсатори, що підганяються
Іноді виникає необхідність конструювання плівкових конденсаторів з підвищеною точністю відтворення ємкості, що перевершує технологічні можливості способу їх виготовлення, а також конденсатори, ємкість яких може змінюватися в певних межах.
Підгонка може здійснюватися як у бік зменшення, так і у бік збільшення ємкості. Конструкція конденсатора, що підганяється, має підганяльні секції. Підганяльні секції можна довільно розміщувати по сторонах верхньої обкладки. При підгонці можливе збільшення ємкості конденсатора за допомогою дротяних перемичок. Додаткова ємність визначається площею обкладання секції, що додатково підключається.[3]
Плівкові індуктивні елементи
Такі елементи широко поширені в аналогових ІМС. Індуктивні елементи входять до складу коливальних контурів автогенераторів, смугових фільтрів, ланцюгів корекції частотних характеристик і так далі. Товщина плівкової спіралі залежить від робочої частоти і визначається глибиною проникнення електромагнітної хвилі в матеріал плівкового провідника. Для виготовлення плівкових спіралей застосовують матеріали з високою електропровідністю.[2]
Елементи комутації
Такі елементи (провідники і контактні площадки) служать для електричного з'єднання компонентів і елементів ІС між собою, а також для приєднання до виводів корпусу.
Електро-фізичні властивості комутаційних провідників і контактних площадок визначаються властивостями вживаних матеріалів, до яких пред'являються наступні вимоги:
1) висока електропровідність;
2) хороша адгезія до підкладки;
3) висока корозійна стійкість;
4) забезпечення низького і відтворного перехідного опору контактів;
5) можливість паяння або зварки виводів навісних компонентів;
6) сумісність технології нанесення плівкових комутаційних провідників і контактних площадок, з технологією виготовлення інших елементів мікросхем.
Найпоширенішим матеріалом тонкоплівкових провідників і контактних майданчиків в ГІС підвищеній надійності є золото з підшаром хрому, ніхрому або титану. Підшар забезпечує високу адгезію, а золото – потрібну електропровідність, високу корозійну стійкість, можливість паяння і зварки.[2]
Плівкові перехідні контакти
Контактний вузол двох плівкових елементів ІС має певний опір, залежний від геометрії і розмірів контакту, електропровідності контактуючих матеріалів, питомого перехідного опору контакту.
Під питомим перехідним опором розуміють опір одиниці площі контактного переходу струму, що протікає по нормалі до шарів контакту.
Цей опір обумовлений розсіянням носіїв струму на неоднорідностях в місці зіткнення двох металевих матеріалів; стрибкоподібною зміною атомної і електронної структури, а також наявністю чужорідних включень в місці контакту. Отже, значення питомого перехідного опору істотно залежить від природи контактуючих матеріалів, а також умов і способу їх формування. [1]
РОЗДІЛ 2. ТЕХНОЛОГІЯ ВИРОБНИЦТВА ІНТЕГРАЛЬНИХ МІКРОСХЕМ
Сукупність технологічних операцій, складових технологічний маршрут виробництва тонкоплівкових ІС, включає підготовку поверхні підкладки, нанесення плівок на підкладку і формування конфігурацій тонкоплівкових елементів, монтаж і збірку навісних компонентів, захист і герметизацію ІС від зовнішніх дій. Важливе значення при створенні ІС мають контрольні операції, а також підготовка виробництва: виготовлення комплекту масок і фотошаблонів, контроль компонентів ІС і початкових матеріалів. [4]
Нанесення плівок на підкладку ІС здійснюється:
а) термічним випаровуванням матеріалів у вакуумі з конденсацією пари цих матеріалів на поверхню підкладки;
б) іонним розпилюванням мішеней з матеріалів, що наносяться, з перенесенням атомів мішеней на поверхню підкладки;
в) хімічним осадженням плівок в результаті протікання хімічних реакцій в газовій фазі над поверхнею підкладки з утворенням плівкотвірної речовини з подальшим його осадженням на підкладку.
Для формування конфігурацій провідного, резистивного і діелектричного шарів використовують різні методи: масковий (відповідні матеріали напилюють на підкладку через знімні маски); фотолітографія (плівку наносять на всю поверхню підкладки, після чого витравляють з певних ділянок); електронно-променевий (деякі ділянки плівки видаляють за заданою програмою з підкладки шляхом випаровування під впливом електронного променя); лазерний (аналогічний електронно-променевому, тільки замість електронного застосовують промінь лазера). Найбільшого поширення набули два перші способи, а також їх поєднання.[3]
Найпростішим методом отримання заданої конфігурації плівкових елементів є масковий, при якому нанесення кожного шару тонкоплівкової структури здійснюється через спеціальний трафарет. При масковому методі рекомендується така послідовність формування шарів ІС:
1) напилення резисторів, провідників і контактних площадок;
2) міжшарова ізоляція;
3) другого шару для перетину провідників;
4) нижніх обкладань конденсаторів;
5) діелектрика;
6) верхніх обкладок конденсаторів;
7) захисного шару.
Плівка з напилюваного матеріалу осідає на підкладці в місцях, відповідних малюнку вікон в масці. Як матеріал знімної маски використовують плівки берилієвої бронзи завтовшки 0,1-0,2 міліметра, покриту шаром нікелю завтовшки близько 10 мкм.
Нанесення плівок через знімні маски здійснюють термічним випаровуванням у вакуумі або іонно-плазмовим розпилюванням.
В результаті викривлення маски в процесі напилення плівки між маскою і підкладкою утворюється зазор, що приводить до підзапалу. Крім того, розміри вікон в масці при багатократному напиленні зменшуються. Все це обумовлює меншу точність даного методу в порівнянні з фотолітографією.
Не дивлячись на недоліки масковий метод є найпростішим, технологічнішим і високопродуктивним. [1]
Цей метод дозволяє отримати конфігурацію елементів будь-якої складності і має велику точність в порівнянні з масковим, проте він складніший.
Існує декілька різновидів фотолітографії. Метод прямої фотолітографії передбачає нанесення суцільної плівки матеріалу тонкоплівкового елементу, формування на її поверхні фоторезистивної контактної маски, витравляння через вікна у фоторезисті зайвих ділянок плівки. Контактна маска з фоторезиста або іншого матеріалу, стійкішого до подальших технологічних дій, відтворює малюнок фотошаблону з плівки. [3]
Експонований фоторезист віддаляється (розчиняється) після чого плівка резистивного матеріалу видаляється з ділянок, не захищених фоторезистом. Далі на підкладці у вакуумі наноситься суцільна плівка алюмінію. Після фотолітографії і травки алюмінієм провідна плівка залишається в областях контактних площадок і провідників. При цьому сформовані на попередньому етапі резистори не ушкоджуються. Після нанесення поверх провідних елементів і резисторів захисного шару скла проводиться ще одна, третя обробка фотолітографії, в результаті якої скло віддаляється з областей над контактними площадками, а також по периметру плати. [1]
Метод зворотної (вибуховий) фотолітографії відрізняється від попереднього тим, що спочатку на підкладці формується контактна маска, потім наноситься матеріал плівкового елементу, після чого проводиться видалення контактної маски.
При методі фотолітографії для виготовлення ІС, що містять резистори і провідники, використовують два технологічні маршрути. Перший варіант – напилення матеріалу резистивної і провідної плівок; фотолітографія провідного шару; фотолітографія резистивного шару; нанесення захисного шару. Другий варіант – після проведення перших двох операцій, тих же що і в попередньому варіанті, спочатку здійснюють фотолітографію і травлять одночасно провідний і резистивний шари, потім другу фотолітографію для видалення провідного шару в місцях формування резистивних елементів, після чого слідує нанесення захисного шару і фотолітографія для розтину вікон в нім над контактними площадками. [2]
При виробництві плівкових мікросхем, що містять провідники і резистори з двох різних (високоомного і низькоомного) резистивних матеріалів, рекомендується така послідовність операцій: почергове напилення плівок спочатку високоомного, потім низькоомного резистивних матеріалів; напилення матеріалу провідної плівки; фотолітографія провідного шару; фотолітографія низькоомного резистивного шару; фотолітографія високоомного резистивного шару; нанесення захисного шару. [2]
2.3 Комбінований метод
При поєднанні маскового методу і фотолітографії методів для мікросхем, що містять резистори, провідники і конденсатори, використовують два варіанти:
1) напилення резисторів через маску, напилення провідної плівки на резистивну; фотолітографія провідного шару; почергове напилення через маску нижніх обкладань, діелектрика і верхніх обкладань конденсатора; нанесення захисного шару;
2) напилення резистивної плівки і провідної плівки на резистивну; фотолітографія провідного і резистивного шарів; фотолітографія провідного шару; напилення через маску нижніх обкладань, діелектрика і верхніх обкладань конденсатора; нанесення захисного шару.
Для схем, що не містять конденсаторів, застосовують один з трьох варіантів:
1) напилення через маску резисторів і провідної плівки; фотолітографія провідного шару; нанесення захисного шару;
2) напилення резистивної плівки; фотолітографія резистивного шару; напилення через маску провідників і контактних майданчиків; нанесення захисного шару;
3) напилення резистивної плівки, а також контактних майданчиків і провідників через маску; фотолітографія резистивного шару; нанесення захисного шару. [1]
РОЗДІЛ 3.
МЕТОДИ МЕТАЛІЗАЦІЇ ІНТЕГРАЛЬНИХ СХЕМ
3.1
Термічне (вакуумне) напилення
Схема цього методу показана на рис 3.1. Металевий або скляний ковпак 1 розташований на опорній плиті 2. Між ними знаходиться прокладка 3, що забезпечує підтримку вакууму після відкачування повітря з під ковпака. Підкладка 4, на яку проводитися напилення, закріплена на утримувачі 5. До утримувача прикріплений нагрівач 6 (напилення проводитися на нагріту підкладку). Випарник 7 включає в себе нагрівач і джерело напилюваної речовини. Поворотна заслінка 8 перекриває потік парі від випарника до підкладки: напилення триває протягом часу, коли заслінка відкрита.[3]

Рис 3.1. Термічне (вакуумне) напилення
Нагрівач зазвичай є ниткою або спіраллю з тугоплавкого металу (вольфрам, молібден і ін.), через який пропускається достатньо великий струм. Джерело напилюваної речовини зв'язується з нагрівачем по-різному: у вигляді дужок, що навішуються на нитку напруження; у вигляді невеликих стержнів, що охоплюються спіраллю, у вигляді порошку, засипаного в тигель, що нагрівається спіраллю і тому подібне. Замість ниток розжарення останнім часом використовують нагрівання за допомогою електронного променя або променя лазера.[3]
На підкладці створюються найбільш сприятливі умови для конденсації пари, хоча частково конденсація пари відбувається і на стінках ковпака. Дуже низька температура підкладки перешкоджає рівномірному розподілу адсорбованих атомів: вони групуються в "острівці" різної товщини, часто не зв'язані один з одним. Навпаки, дуже висока температура підкладки приводить до відриву атомів, що тільки що осіли, до їх "перевипаровування". Тому для отримання якісної плівки температура підкладки повинна лежати в деяких оптимальних межах (зазвичай 200-4000С). Швідкість наростання плівок залежить від ряду чинників (температура нагрівача, температура підкладки, відстань від випарника до підкладки, тип напилюваного матеріалу і ін.) і лежить в межах від десяти до десятків нанометрів в секунду.[3]
Міцність зв'язку – зчеплення плівки з підкладкою або іншою плівкою – називається адгезією. Деякі поширені матеріали (наприклад, золото) мають погану адгезію з типовими підкладками, зокрема з кремнієм. Утаких випадках на підкладку спочатку наносять так званий підшар, характерний хорошою адгезією, а потім на нього напилюють основний матеріал, у якого адгезія з підшаром теж хороша. Наприклад, для золота підшаром можуть бути нікель або титан.[3]
Для того, щоб атоми газу, що летять від випарника до підкладки, зазнавали мінімальну кількість зіткнень з атомами решти газу і тим самим мінімальне розсіювання, в просторі підковпака потрібно забезпечувати достатньо високий вакуум. Критерієм необхідного вакууму може служити умова, щоб середня довжина вільного пробігу у декілька разів перевищувала відстань між випарником і підкладкою. Проте цієї умови часто недостатньо, оскільки будь-яка кількість залишкового газу може стати забрудненням напилюваної плівки і зміною її властивостей. Тому в принципі вакуум в установках термічного напилення має бути якомога вищим. У даний час вакуум нижче 10-6 мм рт. ст. вважається за неприйнятний, а у ряді установок він доведений до 10-11 мм рт. ст.[3]
Головними достоїнствами розглянутого методу є його простота і можливість отримання виключно чистих плівок (при високому вакуумі). Проте у нього є і серйозні недоліки: важкість напилення тугоплавких матеріалів і неможливість відтворення на підкладці хімічного складу випаровуваної речовини. Останнє пояснюється тим, що при високій температурі хімічні сполуки диссоціюють, а їх складові конденсуються на підкладці роздільно. Природною є вірогідність того, що нова комбінація атомів на підкладці не відповідатиме структурі початкової молекули.[3]
3.2 Катодне напилення
Схема цього методу показана на рис.3.2. Тут більшість компонентів ті ж, що і на рис.3.1. Проте відсутній випарник; його місце по розташуванню (і по функціях) займає катод 6, який або складається з напилюваної речовини, або електрично контактує з нею. Роль анода виконує підкладка разом з утримувачем.[3]
Простір підковпака спочатку відкачують до 10-5 – 10-6 мм рт. ст., а потім в нього через штуцер 8 вводять деяку кількість очищеного нейтрального газу (частіше за весь аргон), так що створюється тиск 10-1 – 10-2 мм рт. ст. При подачі високої (2 – 3 кВ) напруги на катод (анод заземляють з міркувань електробезпеки) в просторі анод-катод виникає аномальний тліючий розряд, що супроводиться виділенням – іонної плазми.
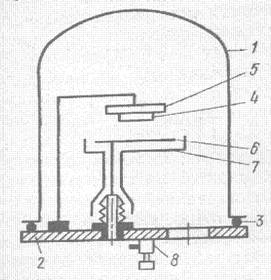
Рис 3.2. Катодне напилення
|
Важливою перевагою катодного напилення в порівнянні з термічним є те, що розпилювання катода не пов'язане з високою температурою. Відповідно відпадають труднощі при напиленні тугоплавких матеріалів і хімічних сполук.[3]
Проте в даному методі катод (тобто напилюваний матеріал), будучи елементом газорозрядного ланцюга, повинний володіти високою електропровідністю. Таку вимогу обмежує асортимент напилюваних матеріалів. Зокрема, виявляється неможливим напилення діелектриків, зокрема багатьох оксидів і інших хімічних сполук, поширених в технології напівпровідникових приладів.[3]
Це обмеження значною мірою усувається при використанні так званого реактивного (або хімічного) катодного напилення, особливість якого полягає в додаванні до основної маси інертного газу невеликої кількості активних газів, здатних утворювати необхідні хімічні сполуки з матеріалом катода, що розпилюється. Наприклад, домішавши до аргону кисень, можна виростити на підкладці плівку оксиду. Домішавши азот або монооксид вуглецю - нітрид або карбіди відповідних металів. В залежності від парціального тиску активного газу хімічна реакція може відбуватися або на катоді (і тоді на підкладці осідає вже готове з'єднання), або на підкладці – аноді.[3]
Недоліками катодного напилення в цілому є деяка забрудненість плівок (через використання порівняно низького вакууму), менша в порівнянні з термічним методом швидкість напилення (з тієї ж причини), а також складність контролю процесів.[3]
3.3 Іонно-плазмове напилення
Рис 3.3. Іонно-плазмове напилення
Схема цього методу показана на рис 3.3. Головна його особливість в порівнянні з методом катодного напилення полягає в тому, що в проміжку між електродом 9 – мішенню (з нанесеним на неї напилюваним матеріалом) і підкладкою 4 діє незалежний, "черговий" газовий розряд. Розряд має місце між електродами 6 і 7, причому тип розряду – несамостійний дуговий. Для цього типу розряду характерні: наявність спеціального джерела електронів у вигляді розжарюваного катода (6), низька робоча напруга (десятки вольт) і велика щільність електронно-іонної плазми. Простір підковпака, як і при катодному напиленні, заповнений нейтральним газом, але при нижчому тиску (10-3 – 10-4мм рт. ст.).[3]
Процес напилення полягає в наступному. На мішень щодо плазми (практично – щодо заземленого анода 7) подається від’ємний потенціал (2-3кВ), достатній для виникнення аномального тліючого розряду і інтенсивного бомбардування позитивними іонами плазми. Атоми мішені потрапляють на підкладку і осідають на ній. Таким чином, принципових відмінностей між процесами катодного і іонно-плазмового напилення немає. Розрізняють лише конструкції установок: їх називають відповідно 2-х і 3-х електродними.[3]
Початок і кінець процесу напилення визначаються подачею і відключенням напруги на мішені. Якщо передбачити механічну заслінку, то її наявність дозволяє реалізувати важливу додаткову можливість: якщо до початку напилення закрити заслінку і подати потенціал на мішень, то матиме місце іонне очищення мішені. Воно корисне для підвищення якості напилюваної плівки. Аналогічне очищення можна проводити на підкладці, подаючи на неї (до напилення плівки) негативний потенціал.[3]
При напиленні діелектричних плівок виникає трудність, пов'язана з накопиченням на мішені позитивного заряду, що перешкоджає подальшому іонному бомбардуванню. Це долається шляхом використання так званого високочастотного іонно-плазмового напилення. У цьому випадку на мішень на ряду з постійною негативною напругою подається змінна напруга високої частоти (близько 15 МГц) з амплітудою, що перевищує постійну напругу. Тоді під час більшої частини процесу результуюча напруга негативна; при цьому відбувається звичайний процес розпилювання мішені і на ній накопичується позитивний заряд. Проте під час невеликої частини процесу результуюча напруга позитивна; при цьому мішень бомбардується електронами, тобто розпилювання не відбувається, та зате компенсується накопичений позитивний заряд.[3]
Варіант реактивного (хімічного) іонно-плазмового напилення відкриває ті ж можливості отримання оксидів, нітриду і інших з'єднань, що і реактивне катодне напилення.[3]
Переваги іонно-плазмового методу в порівнянні з катодним полягають в більшій швидкості напилення і більшій гнучкості процесу (можливість іонного очищення, можливість відключення робочого ланцюга без переривання розряду і ін.). Крім того, на якості плівок позначається вищий вакуум.[3]
3.4 Анодування
Один з варіантів хімічного іонно-плазмового напилення називають анодуванням. Цей процес полягає в окисленні поверхні металевої плівки (що знаходиться під позитивним потенціалом) негативними іонами кисню, що поступають з плазми газового розряду. Для цього до інертного газу (як і при чисто хімічному напиленні) слід додати кисень. Тому, що анодування здійснюється не нейтральними атомами, а іонами.[1]
Хімічне напилення і анодування проходять спільно, оскільки в газорозрядній плазмі (якщо вона містить кисень) співіснують нейтральні атоми і іони кисню. Для того, щоб анодування переважало над чисто хімічним напиленням, підкладку розташовують лицем (тобто металевою плівкою) убік, протилежно катоду, щоб на неї не попадали нейтральні атоми.
У міру наростання окисного шару струм в анодному ланцюзі падає, оскільки оксид є діелектриком. Для підтримки струму потрібно підвищувати живлячу напругу. Оскільки частина цієї напруги падає на плівці, процес анодування протікає в умовах великої напруженості поля в окисній плівці. У результаті і надалі вона володіє підвищеною електричною міцністю.[1]
До інших переваг анодування відносяться велика швидкість окислення і можливість управління процесом шляхом зміни струму в ланцюзі розряду. Якість оксидних плівок, що отримуються даним методом, вище, ніж при використанні інших методів.[1]
3.5 Електрохімічне осадження
Цей метод отримання плівок відрізняється від попередніх тим, що робочим середовищем є рідина. Проте характер процесів схожий з іонно-плазмовим напиленням, оскільки і плазма і електроліт є квазінейтральною сумішшю іонів і неіонізованих молекул або атомів. А головне, осадження відбувається також поступово (пошарово) як і напилення, тобто забезпечує можливість отримання тонких плівок.[2]
Електрохімічне осадження історично розвинулося значно раніше за інші розглянуті методи – ще в XIX столітті. Вже десятки років назад воно широко використовувалося в машинобудуванні для різного роду гальванічних покриттів (нікелювання, хромування і т. п.). У мікроелектроніці електрохімічне осадження не є альтернативою термічному і іонно-плазмовому напиленню; воно доповнює їх і поєднується з ними.[4]
У основі електрохімічного осадження лежить електроліз розчину, що містить іони необхідних домішок. Наприклад, якщо потрібно осадити мідь, використовується розчин мідного купоросу, а якщо золото або нікель – розчини відповідних солей.[4]
Іони металів дають в розчині позитивний заряд. Тому, щоб осадити металеву плівку, підкладку слід використовувати як катод. Якщо підкладка є діелектриком або має низьку провідність, на неї заздалегідь наносять тонкий металевий підшар, який і служить катодом. Підшар можна нанести методом термічного або іонно-плазмового напилення.[4]
Щоб здійснити електрохімічне анодування, окислювану плівку металу слід використовувати як анод, а електроліт повинен містити іони кисню.
Велика перевага електрохімічного осадження перед напиленням полягає в набагато більшій швидкості процесу, яка легко регулюється зміною струму. Тому основна сфера застосування електролізу в мікроелектроніці – це отримання порівняльне товстих плівок (10 – 20 мкм і більш). Якість (структура) таких плівок гірша, ніж при напиленні, але для ряду застосувань, плівки виявляються цілком прийнятними.[5]
ВИСНОВКИ
В даній курсовій роботі розглянуто компоненти та елементи інтегральних мікросхем.
1. Інтегральна схема - електронний прилад, який складається з багатьох мініатюрних транзисторів та інших елементів схеми, об'єднаних у моноблок (чіп).
2. Сукупність технологічних операцій, складових технологічний маршрут виробництва тонкоплівкових ІС, включає підготовку поверхні підкладки, нанесення плівок на підкладку і формування конфігурацій тонкоплівкових елементів, монтаж і збірку навісних компонентів, захист і герметизацію ІС від зовнішніх дій. Важливе значення при створенні ІС мають контрольні операції, а також підготовка виробництва: виготовлення комплекту масок і фотошаблонів, контроль компонентів ІС і початкових матеріалів.
3. Нанесення плівок на підкладку ІС здійснюється:
а) термічним випаровуванням матеріалів у вакуумі з конденсацією пари цих матеріалів на поверхню підкладки;
б) іонним розпилюванням мішеней з матеріалів, що наносяться, з перенесенням атомів мішеней на поверхню підкладки;
в) хімічним осадженням плівок в результаті протікання хімічних реакцій в газовій фазі над поверхнею підкладки з утворенням плівкотвірної речовини з подальшим його осадженням на підкладку.
1. Малышев И.А. "Технология производства интегральных микросхем". – М.: Радио и связь, 1991.
2. В.А. Хрусталев. Нанесение тонких пленок в вакууме методами термического испарения и ионно-плазменного распыления. / Машиностроение. Энциклопедия / Ред. совет: К.В. Фролов и др. – М.: Машиностроение. Технологии, оборудование и системы управления в электронном машиностроении. Т. III-8 / Ю.В. Панфилов, Л.К. Ковалев, В.Г. Блохин и др.; Под общ. ред. Ю.В. Панфилова. 2000, с.208-213.
3. Технология вакуумной металлизации полимерных материалов. / Ю.В. Липин, А.В. Рогачев, С.С. Сидорский, В.В. Харитонов. – Гомель: Гомельское отдел. Белорус. инж. технологич. академии, 1994. – 206 с.
4. Козлов В.М. Новое оборудование и технологические процессы для нанесения покрытий в вакууме // Труды постоянно действующего научно-технического семинара "Электровакуумная техника и технология" (за 1997/98 гг.) Под ред. А.В. Горина – М.: 1999.
5. Одиноков В.В. Современное вакуумное оборудование для нанесения пленок магнетронным распылением в микроэлектронике // Труды постоянно действующего научно-технического семинара "Электровакуумная техника и технология" (за 1997/98 гг.) Под ред. А.В. Горина – М.: 1999.
6. Ядин Э.В., Аусвальд Э.Я. Вакуумные установки для металлизации рулонных материалов. / Металлизация в вакууме, Рига: "АВОТС", 1983, с. 89-101.